
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Vilka är LPCVD-processerna?
Lågtryckskemisk ångavsättning (LPCVD) processer är CVD-tekniker som avsätter tunna filmmaterial på waferytor under lågtrycksmiljöer. LPCVD-processer används i stor utsträckning inom materialavsättningsteknik för halvledartillverkning, optoelektronik och tunnfilmssolceller.
Reaktionsprocesserna för LPCVD utförs vanligtvis i en lågtrycksreaktionskammare, vanligtvis vid ett tryck på 1–10 Torr. Efter att skivan har upphettats till det temperaturintervall som är lämpligt för avsättningsreaktionen, införs gasformiga prekursorer i reaktionskammaren för avsättning. De reaktiva gaserna diffunderar till skivans yta och genomgår sedan kemiska reaktioner på skivans yta vid höga temperaturer för att bilda fasta avlagringar (tunna filmer).
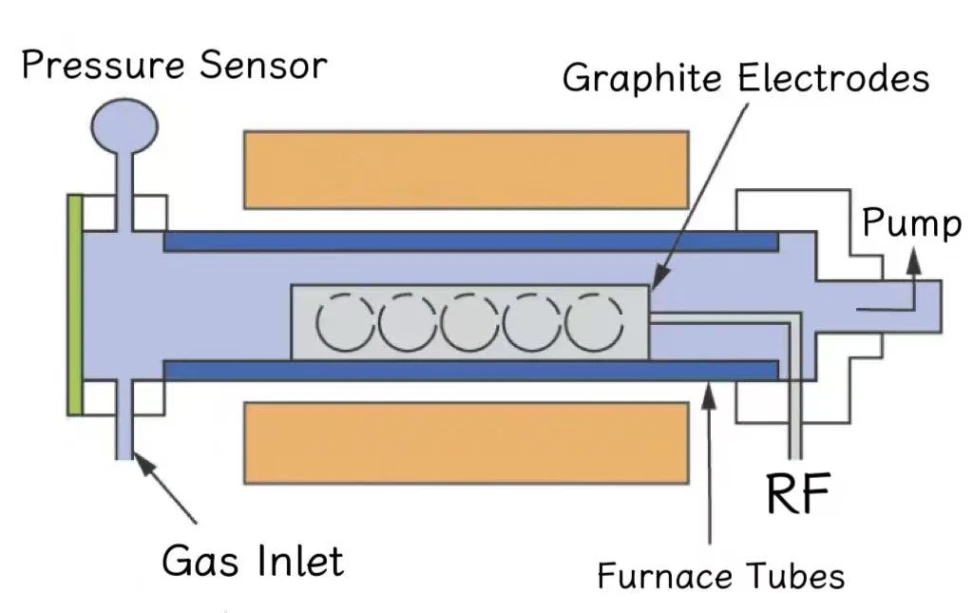
Fördelar med LPCVD-processer
1. Högkvalitativ tunnfilmsavsättningskvalitet
Transporthastigheten för reaktantgaserna ökar när trycket är lågt eftersom diffusionskoefficienten för gaserna ökar. Således kan en mer enhetlig fördelning av gasmolekyler skapas genom hela reaktionskammaren, vilket säkerställer att gasmolekyler reagerar helt med skivans yta och avsevärt minskar hålrum eller tjockleksskillnader orsakade av ofullständiga reaktioner.
2.Utmärkt denna film steg täckning
Den förbättrade gasdiffusionsförmågan under lågt tryck gör att den kan tränga djupt in i komplexa strukturer. Detta säkerställer att den reaktiva gasen är i full kontakt med stegen och dikena på skivans yta, vilket uppnår enhetlig avsättning av tunna filmer. Som ett resultat är tunnfilmsavsättning på intrikata strukturer en bra tillämpning för LPCVD-metoden.
3. Stark operativ styrbarhet
LPCVD-processer uppvisar stark kontrollerbarhet under faktisk drift. Den tunna filmens sammansättning, struktur och tjocklek kan kontrolleras exakt genom att justera reaktantgasparametrar som typ, flödeshastighet, temperatur och tryck. LPCVD-utrustning har relativt låga investerings- och driftskostnader i jämförelse med andra deponeringstekniker, vilket gör den lämplig för storskalig industriell produktion. Och konsekvensen i processerna under massproduktion kan effektivt säkerställas med automatiserade system som övervakar och justerar i realtid.
Nackdelar med LPCVD-processer
Eftersom LPCVD-processer vanligtvis utförs vid höga temperaturer, vilket begränsar användningen av vissa temperaturkänsliga material, måste wafers som måste bearbetas med LPCVD vara värmebeständiga. Under LPCVD-processer kan oönskade problem uppstå, såsom wafer-wrap-around-avsättning (tunna filmer avsatta i icke-målområden av wafern) och svårigheter med in-situ doping, som kräver efterföljande bearbetning för att lösas. Dessutom kan den låga koncentrationen av ångprekursorer under lågtrycksförhållanden leda till en lägre tunnfilmsavsättningshastighet, vilket resulterar i ineffektiv produktionseffektivitet.
Semicorex erbjuder hög kvalitetSiC furnace tubs, Sic fribärande paddlarochSiC waferbåtarför LPCVD-processer. Om du har några frågor eller behöver ytterligare information, tveka inte att kontakta oss.
Kontakta telefonnummer +86-13567891907
E-post: sales@semicorex.com





