
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Plasmaprocesser i CVD-operationer
1. Kammarstädning
Under processen för kemisk ångavsättning (CVD) bildas avlagringar inte bara på ytan av skivan utan även på komponenter i processkammaren och dess väggar. Filmerna som avsatts på delar måste tas bort regelbundet för att bibehålla stabila processförhållanden och förhindra partikelkontamination av skivorna. De flesta CVD-kammare använder fluorbaserade kemiska reaktionsgaser för rengöring.
I kiseloxid-CVD-kammare involverar plasmarening vanligtvis fluorkolgaser som CF4, C2F6 och C3F8, som sönderdelas i plasman och frigör fluorradikaler. De kemiska reaktionerna representeras enligt följande:
·e- + CF4 -> CF3 + F + e-
· e- + C2F6 -> C2F5 + F + e-
Fluoratomer, som är bland de mest reaktiva radikalerna, reagerar snabbt med kiseloxid för att bilda gasformig SiF4, som lätt kan evakueras från kammaren:
·F + SiO2 -> SiF4 + O2 + andra flyktiga biprodukter
Volfram CVD-kammare använder vanligtvis SF6 och NF3 som källor till fluor. Fluorradikaler reagerar med volfram för att producera flyktig volframhexafluorid (WF6), som kan evakueras från kammaren via vakuumpumpar. Rengöring av plasmakammaren kan avslutas automatiskt genom att övervaka emissionsegenskaperna för fluor i plasman, vilket undviker överdriven rening av kammaren. Dessa aspekter kommer att diskuteras mer i detalj.
2. Gap Fyll
När gapet mellan metalllinjerna minskar till 0,25 µm med ett bildförhållande på 4:1, kämpar de flesta CVD-avsättningstekniker för att fylla luckorna utan tomrum. High-Density Plasma CVD (HDP-CVD) kan fylla så smala luckor utan att skapa tomrum (se figur nedan). HDP-CVD-processen kommer att beskrivas senare.
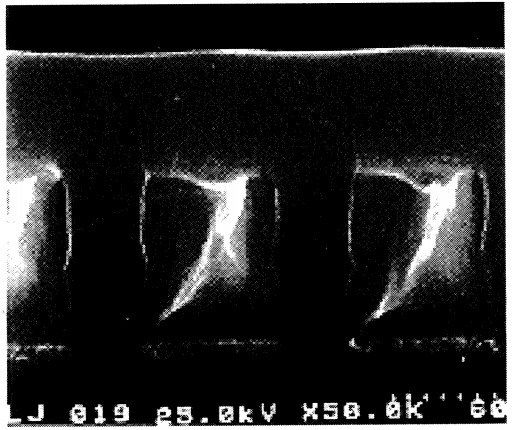
3. Plasmaetsning
Jämfört med våtetsning erbjuder plasmaetsning fördelar såsom anisotropiska etsningsprofiler, automatisk slutpunktsdetektion och lägre kemikalieförbrukning, tillsammans med rimliga höga etsningshastigheter, god selektivitet och enhetlighet.
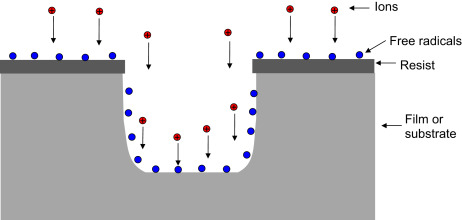
4. Kontroll av Etch-profiler
Innan plasmaetsning blev utbredd inom halvledartillverkning använde de flesta waferfabs våtkemisk etsning för mönsteröverföring. Våtetsning är dock en isotrop process (etsning i samma takt i alla riktningar). När detaljstorlekar krymper under 3 µm, resulterar isotrop etsning i underskärning, vilket begränsar tillämpningen av våtetsning.
I plasmaprocesser bombarderar joner kontinuerligt skivans yta. Oavsett om det är genom mekanismer för gallerskada eller passiveringsmekanismer för sidoväggar, kan plasmaetsning uppnå anisotropa etsningsprofiler. Genom att minska trycket under etsningsprocessen kan den genomsnittliga fria banan för joner ökas, och därigenom minska jonkollisioner för bättre profilkontroll.
5. Etsningshastighet och selektivitet
Jonbombardement i plasma hjälper till att bryta de kemiska bindningarna av ytatomer och utsätta dem för radikaler som genereras av plasman. Denna kombination av fysisk och kemisk behandling ökar avsevärt den kemiska reaktionshastigheten vid etsning. Etsningshastigheten och selektiviteten dikteras av processkraven. Eftersom både jonbombardement och radikaler spelar en avgörande roll vid etsning, och RF-kraft kan styra jonbombardement och radikaler, blir RF-effekt en nyckelparameter för att kontrollera etsningshastigheten. Att öka RF-effekten kan avsevärt förbättra etsningshastigheten, vilket kommer att diskuteras mer i detalj, vilket också påverkar selektiviteten.
6. Slutpunktsdetektering
Utan plasma måste etsningsslutpunkten bestämmas genom tid eller visuell inspektion av operatören. I plasmaprocesser, när etsningen fortskrider genom ytmaterialet för att börja etsa det underliggande (slutpunkts-) materialet, förändras plasmans kemiska sammansättning på grund av förändringen i etsningsbiprodukter, uppenbar genom en förändring i emissionsfärgen. Genom att övervaka förändringen i emissionsfärg med optiska sensorer kan etsningsändpunkten bearbetas automatiskt. Inom IC-produktion är detta ett mycket värdefullt verktyg.**




