
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Förstå torretsningsteknik i halvledarindustrin
Etsning hänvisar till tekniken att selektivt avlägsna material genom fysiska eller kemiska metoder för att uppnå de designade strukturmönstren.
För närvarande använder många halvledarenheter mesa-enhetsstrukturer, som huvudsakligen skapas genom två typer av etsning:våt- och torretsning. Även om den enkla och snabba våtetsningen spelar en betydande roll vid tillverkning av halvledaranordningar, har den inneboende nackdelar såsom isotropisk etsning och dålig enhetlighet, vilket resulterar i begränsad kontroll vid överföring av små mönster. Torretsning har emellertid, med dess höga anisotropi, goda enhetlighet och repeterbarhet, blivit framträdande i tillverkningsprocesser för halvledaranordningar. Termen "torr etsning" syftar i stora drag på all icke-våtetsningsteknik som används för att ta bort ytmaterial och överföra mikro- och nanomönster, inklusive laseretsning, plasmaetsning och kemisk ångetsning. Den torretsning som diskuteras i denna text hänför sig specifikt till den snäva tillämpningen av processer som använder plasmaurladdning – antingen fysisk eller kemisk – för att modifiera materialytor. Den täcker flera vanliga industriella etsningstekniker, inklusiveJonstråleetsning (IBE), reaktiv jonetsning (RIE), plasmaetsning med elektroncyklotronresonans (ECR) och induktivt kopplad plasmaetsning (ICP).
1. Jonstråleetsning (IBE)
Även känd som jonfräsning, utvecklades IBE på 1970-talet som en rent fysisk etsningsmetod. Processen involverar jonstrålar skapade av inerta gaser (som Ar, Xe) som accelereras av en spänning för att bombardera målmaterialets yta. Jonerna överför energi till ytatomerna, vilket gör att de med energi som överstiger sin bindningsenergi sprattlar bort. Denna teknik använder accelererad spänning för att styra jonstrålens riktning och energi, vilket resulterar i utmärkt etsningsanisotropi och hastighetskontrollerbarhet. Även om det är idealiskt för etsning av kemiskt stabila material som keramik och vissa metaller, kan behovet av tjockare masker för djupare etsningar äventyra etsningsprecisionen, och högenergijonbombardementet kan orsaka oundvikliga elektriska skador på grund av galleravbrott.

2. Reaktiv jonetsning (RIE)
Utvecklat från IBE kombinerar RIE kemiska reaktioner med fysiskt jonbombardement. Jämfört med IBE erbjuder RIE högre etsningshastigheter och utmärkt anisotropi och enhetlighet över stora ytor, vilket gör det till en av de mest använda etsningsteknikerna inom mikro- och nanotillverkning. Processen involverar att applicera radiofrekvensspänning (RF) på parallella plattelektroder, vilket får elektroner i kammaren att accelerera och jonisera reaktionsgaserna, vilket leder till ett stabilt plasmatillstånd på ena sidan av plattorna. Plasmat har en positiv potential på grund av att elektroner dras till katoden och jordas vid anoden, vilket skapar ett elektriskt fält över kammaren. Den positivt laddade plasman accelererar mot det katodkopplade substratet och etsar det effektivt.
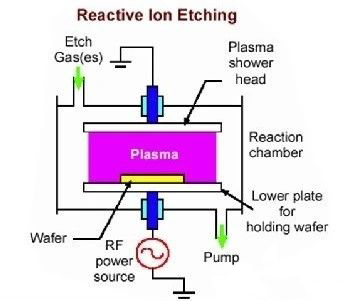
Under etsningsprocessen upprätthåller kammaren en lågtrycksmiljö (0,1~10 Pa), vilket ökar joniseringshastigheten för reaktionsgaserna och accelererar den kemiska reaktionsprocessen vid substratytan. I allmänhet kräver RIE-processen att reaktionsbiprodukterna är flyktiga för att effektivt avlägsnas av vakuumsystemet, vilket säkerställer hög etsningsprecision. RF-effektnivån bestämmer direkt plasmadensiteten och accelerationsförspänningen och styr därigenom etsningshastigheten. Men samtidigt som plasmadensiteten ökar, ökar RIE också förspänningen, vilket kan orsaka gallerskada och minska maskens selektivitet, vilket innebär begränsningar för etsningsapplikationer. Med den snabba utvecklingen av storskaliga integrerade kretsar och den minskande storleken på transistorer har det funnits en större efterfrågan på precision och bildförhållanden inom mikro- och nanotillverkning, vilket leder till tillkomsten av högdensitetsplasmabaserade torretsningstekniker, vilket ger nya möjligheter för utvecklingen av elektronisk informationsteknik.
3. Elektroncyklotronresonans (ECR) Plasmaetsning
ECR-teknik, en tidig metod för att uppnå plasma med hög densitet, använder mikrovågsenergi för att resonera med elektroner i kammaren, förstärkt av ett externt applicerat, frekvensanpassat magnetfält för att inducera elektroncyklotronresonans. Denna metod uppnår betydligt högre plasmadensiteter än RIE, vilket förbättrar etsningshastigheten och maskselektiviteten, vilket underlättar etsningen av strukturer med ultrahögt bildförhållande. Systemets komplexitet, som förlitar sig på samordnad funktion hos mikrovågskällor, RF-källor och magnetfält, utgör dock operativa utmaningar. Framväxten av Inductively Coupled Plasma (ICP) etsning följde snart som en förenkling jämfört med ECR.
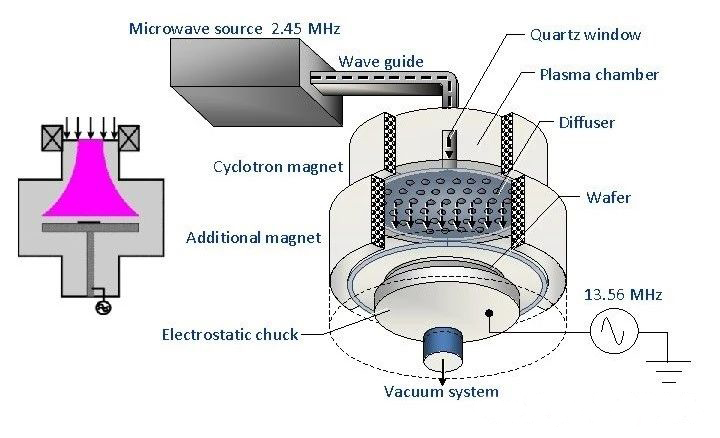
4. Induktivt kopplad plasma (ICP) etsning
ICP-etsningsteknik förenklar systemet baserat på ECR-teknik genom att använda två 13,56MHz RF-källor för att kontrollera både plasmagenerering och accelerationsförspänningen. Istället för det externa magnetiska fältet som används i ECR, inducerar en spiralspole ett växlande elektromagnetiskt fält, som visas i schemat. RF-källorna överför energi genom elektromagnetisk koppling till de inre elektronerna, som rör sig i en cyklotronrörelse inom det inducerade fältet och kolliderar med reaktionsgaserna för att orsaka jonisering. Denna inställning uppnår plasmadensiteter jämförbara med ECR. ICP-etsning kombinerar fördelarna med olika etsningssystem, som möter behoven av höga etshastigheter, hög selektivitet, enhetlighet i stort område och enkel, kontrollerbar utrustningsstruktur, och blir därmed snabbt det föredragna valet för en ny generation av högdensitetsplasmaetsningsteknologier .
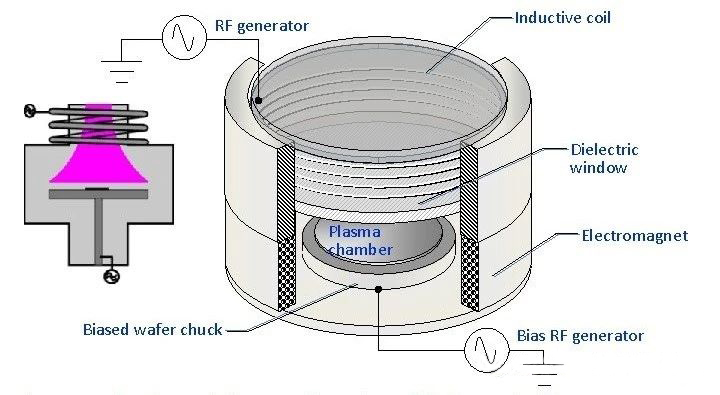
5. Egenskaper för torretsning
Torretsningsteknik har snabbt tagit en huvudposition inom mikro- och nanotillverkning på grund av dess överlägsna anisotropi och höga etsningshastigheter, och ersätter våtetsning. Kriterierna för att utvärdera bra torretsningsteknik inkluderar maskselektivitet, anisotropi, etsningshastighet, övergripande likformighet och ytjämnhet från gallerskada. Med många utvärderingskriterier måste den specifika situationen beaktas utifrån tillverkningsbehov. De mest direkta indikatorerna på torretsning är ytmorfologin, inklusive planheten hos det etsade golvet och sidoväggarna och anisotropin hos de etsade terrasserna, som båda kan kontrolleras genom att justera förhållandet mellan kemiska reaktioner och fysiskt bombardement. Mikroskopisk karakterisering efter etsning utförs vanligtvis med användning av svepelektronmikroskopi och atomkraftsmikroskopi. Maskselektivitet, som är förhållandet mellan maskens etsdjup och materialets under samma etsningsförhållanden och tid, är avgörande. Generellt gäller att ju högre selektivitet, desto bättre är noggrannheten i mönsteröverföringen. Vanliga masker som används vid ICP-etsning inkluderar fotoresist, metaller och dielektriska filmer. Fotoresist har dålig selektivitet och kan brytas ned under höga temperaturer eller energiskt bombardement; metaller erbjuder hög selektivitet men utgör utmaningar vid maskborttagning och kräver ofta flerskiktsmaskeringstekniker. Dessutom kan metallmasker fästa vid sidoväggarna under etsning och bilda läckagevägar. Därför är valet av lämplig maskteknik särskilt viktigt för etsning, och valet av maskmaterial bör bestämmas baserat på de specifika prestandakraven för enheterna.**




