
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Om halvledarvärmeelement
Värmebehandling är en av de väsentliga och viktiga processerna i halvledarprocessen. Termisk process är processen att applicera termisk energi på en wafer genom att placera den i en miljö fylld med en specifik gas, inklusive oxidation/diffusion/glödgning, etc.
Värmebehandlingsutrustning används huvudsakligen i oxidation, diffusion, glödgning och legering fyra typer av processer.
Oxidationplaceras i kiselskivan i atmosfären av syre eller vattenånga och andra oxidanter för värmebehandling vid hög temperatur, den kemiska reaktionen på skivans yta för att bilda en oxidfilmprocess, är en av de mer allmänt använda i den integrerade kretsprocessen i den grundläggande processen. Oxidationsfilm har ett brett användningsområde, kan användas som ett blockerande skikt för joninjektion och injektionspenetreringsskikt (skadabuffertskikt), ytpassivering, isolerande grindmaterial och enhetsskyddslager, isoleringsskikt, enhetsstruktur för det dielektriska lagret och så vidare.
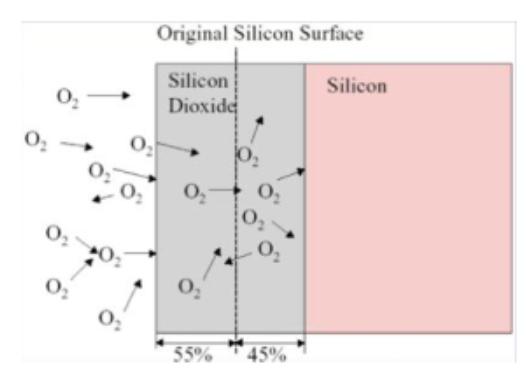
Diffusionär i höga temperaturer, användningen av termisk diffusion principen för föroreningar element enligt processkraven dopad in i kisel substrat, så att det har en specifik koncentration distribution, för att ändra de elektriska egenskaperna hos materialet, bildandet av halvledarenhet struktur. I processen med integrerade kiselkretsar används diffusionsprocessen för att göra PN-övergång eller utgöra integrerade kretsar i resistans, kapacitans, sammankopplingsledningar, dioder och transistorer och andra enheter.
Glödga, även känd som termisk glödgning, integrerad kretsprocess, allt i kväve och annan inaktiv atmosfär i värmebehandlingsprocessen kan kallas glödgning, dess roll är främst att eliminera gitterdefekter och eliminera gitterskador på kiselstrukturen.
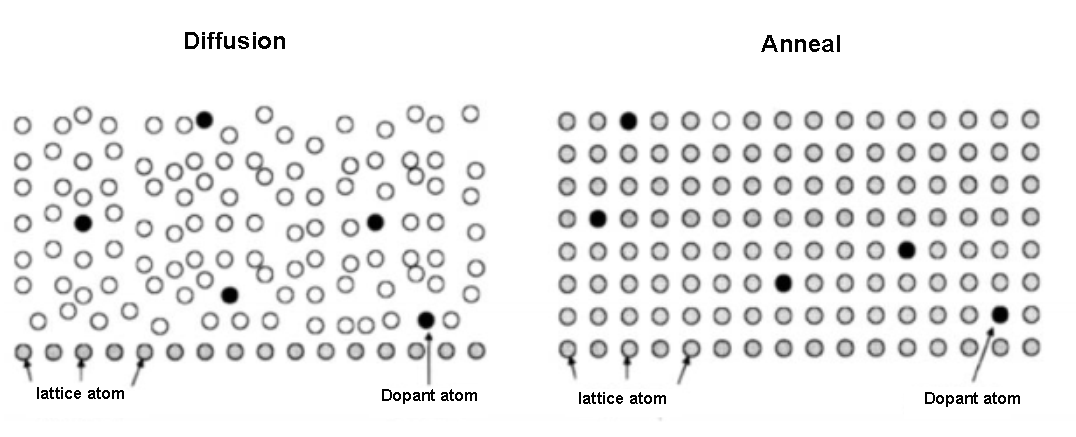
Legeringär en lågtemperaturvärmebehandling som vanligtvis krävs för att placera kiselskivor i en inert gas- eller argonatmosfär för att bilda en bra bas för metallerna (Al och Cu) och kiselsubstratet, samt för att stabilisera den kristallina strukturen hos Cu-ledningarna och för att avlägsna föroreningar, vilket förbättrar ledningarnas tillförlitlighet.
Enligt utrustningsformen kan värmebehandlingsutrustning delas in i vertikal ugn, horisontell ugn och snabb termisk bearbetningsugn (Rapid Thermal Processing, RTP).
Vertikal ugn:Det huvudsakliga styrsystemet för vertikal ugn är uppdelat i fem delar: ugnsrör, waferöverföringssystem, gasdistributionssystem, avgassystem, kontrollsystem. Ugnsrör är platsen för uppvärmning av kiselskivor, som består av vertikala kvartsbälgar, flerzons värmemotståndstrådar och värmerörshylsor. Huvudfunktionen hos waferöverföringssystemet är att ladda och lossa wafers i ugnsröret. Lastning och lossning av wafers åstadkoms av automatiska maskiner, som rör sig mellan wafer rack-bordet, ugnsbordet, wafer-laddningsbordet och kylbordet. Gasdistributionssystemet överför rätt gasflöde till ugnsröret och upprätthåller atmosfären inuti ugnen. Avgassystemet är placerat i ett genomgående hål i ena änden av ugnsröret och används för att helt avlägsna gasen och dess biprodukter. Styrsystemet (mikrokontrollern) styr alla ugnsoperationer, inklusive processtid och temperaturkontroll, sekvens av processsteg, gastyp, gasflödeshastighet, hastighet för temperaturstegring och -fall, laddning och urladdning av wafers, etc. Varje mikrokontroller har ett gränssnitt med en värddator. Jämfört med horisontella ugnar minskar vertikala ugnar fotavtryck och möjliggör bättre temperaturkontroll och enhetlighet.
Horisontell ugn:Dess kvartsrör är placerat horisontellt för att placera och värma kiselskivorna. Dess huvudsakliga kontrollsystem är uppdelat i 5 sektioner som den vertikala ugnen.
Rapid Thermal Processing Furnace (RTP): Rapid Temperature Rising Furnace (RTP) är ett litet, snabbt uppvärmningssystem som använder infraröda halogenlampor som värmekälla för att snabbt höja skivans temperatur till bearbetningstemperaturen, vilket minskar tiden som behövs för processstabilisering och kyler skivan snabbt i slutet av processen. Jämfört med traditionella vertikala ugnar är RTP mer avancerad när det gäller temperaturkontroll, med de största skillnaderna är dess komponenter för snabb uppvärmning, speciella waferladdningsanordningar, forcerad luftkylning och bättre temperaturkontroller. Den speciella waferladdningsanordningen ökar gapet mellan wafers, vilket möjliggör mer enhetlig uppvärmning eller kylning mellan wafers. Medan konventionella vertikala ugnar använder termoelement,-RT-temperaturkontroll och temperaturkontroll (T-RT) ces använder modulära temperaturkontroller som tillåter kontroll av individuell uppvärmning och kylning av wafers, snarare än att bara kontrollera atmosfären inuti ugnen. Dessutom finns det en avvägning mellan höga wafervolymer (150-200 wafers) och ramphastigheter, och RTP är lämplig för mindre batcher (50-100 wafers) eftersom få bearbetas med samma mängd wafers, eftersom det också är få som bearbetas med små wafers. s lokala luftflöde i processen.
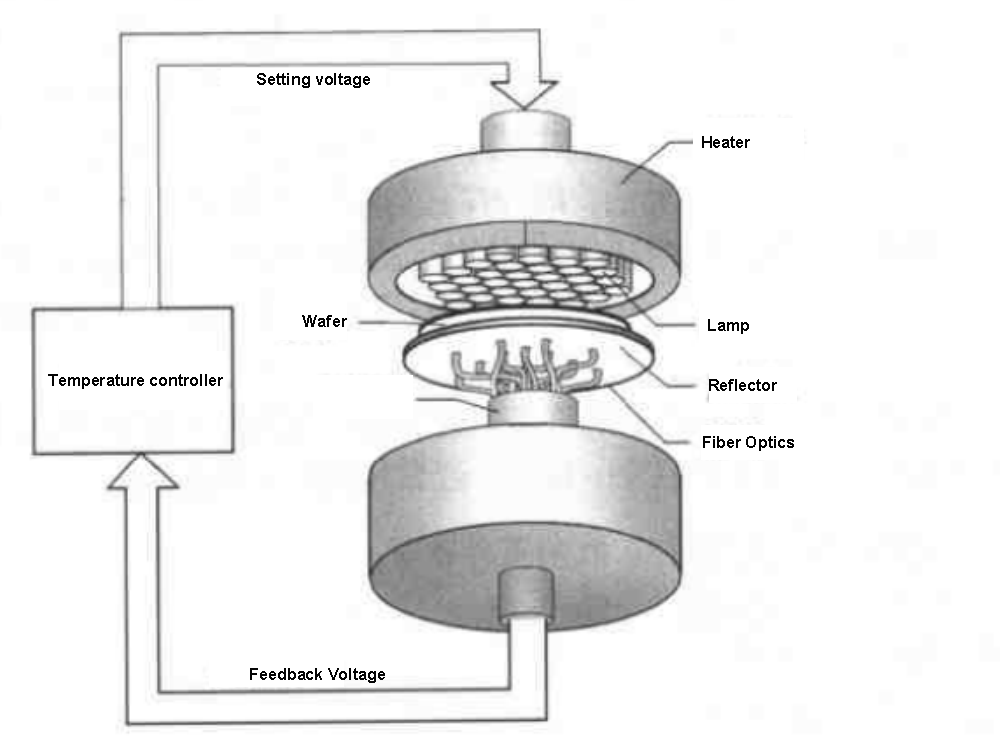
Semicorex är specialiserat påSiC-delar med CVD SiC-beläggningarför halvledarprocesser, såsom rör, fribärande paddlar, waferbåtar, waferhållare, etc. Om du har några frågor eller behöver ytterligare information är du välkommen att kontakta oss.
Kontakt Telefon #+86-13567891907
E-post:sales@semicorex.com




