
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Vanliga avbindningsmetoder
Med framsteg inom halvledarbearbetning och ökande efterfrågan på elektroniska komponenter har tillämpningen av ultratunna wafers (tjocklek mindre än 100 mikrometer) blivit allt mer kritisk. Men med pågående minskningar av wafertjocklek är wafers mycket känsliga för brott under efterföljande processer, såsom slipning, etsning och metallisering.
Teknik för temporär bindning och avbindning används vanligtvis för att garantera stabil prestanda och produktionsutbyte för halvledarenheter. Den ultratunna skivan fixeras tillfälligt på ett styvt bärarsubstrat och efter bearbetning på baksidan separeras de två. Denna separationsprocess är känd som avbindning, som i första hand inkluderar termisk avbindning, laseravbindning, kemisk avbindning och mekanisk avbindning.
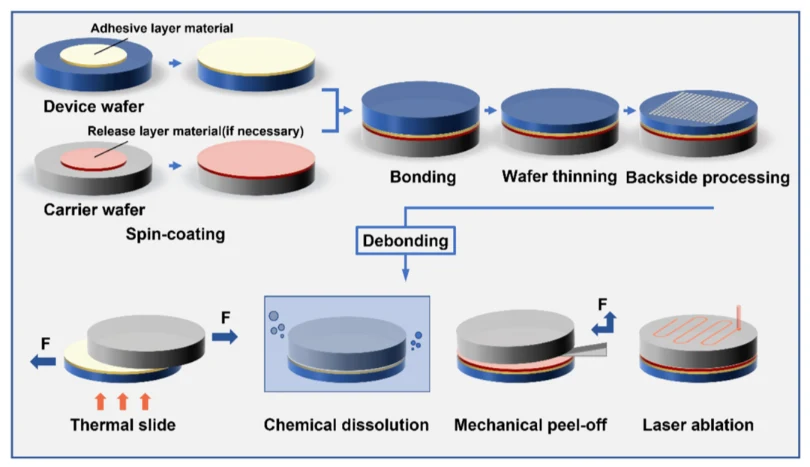
Termisk avbindning
Termisk avbindning är en metod som separerar ultratunna wafers från bärarsubstrat genom att värma upp för att mjuka upp och sönderdela limmet och därigenom förlora sin vidhäftningsförmåga. Det är huvudsakligen uppdelat i termisk glidavbindning och termisk sönderdelningsavbindning.
Termisk glidavbindning involverar vanligtvis uppvärmning av bundna wafers till deras mjukningstemperatur, som sträcker sig ungefär från 190°C till 220°C. Vid denna temperatur förlorar bindemedlet sin vidhäftningsförmåga och ultratunna skivor kan långsamt skjutas eller skalas av bärarsubstrat genom skjuvkraften som appliceras av enheter som t.ex.vakuumchuckarför att uppnå en jämn separation. Medan den termiska sönderdelningen avbinds, värms bundna wafers till en högre temperatur, vilket orsakar kemisk sönderdelning (molekylkedjeklyvning) av limmet och förlorar fullständigt dess vidhäftning. Som ett resultat kan bundna wafers tas bort naturligt utan någon mekanisk kraft.
Laseravbindning
Laseravbindning är en avbindningsmetod som använder laserbestrålning på det vidhäftande skiktet av bundna wafers. Det vidhäftande skiktet absorberar laserenergin och genererar värme och genomgår därigenom en fotolytisk reaktion. Detta tillvägagångssätt möjliggör separation av ultratunna wafers från bärarsubstrat vid rumstemperatur eller relativt låga temperaturer.
En avgörande förutsättning för laseravbindning är dock att bärarsubstratet måste vara transparent för laservåglängden som används. På detta sätt kan laserenergin framgångsrikt penetrera bärarsubstratet och effektivt absorberas av bindeskiktsmaterialet. Av denna anledning är valet av laservåglängd avgörande. Typiska våglängder inkluderar 248 nm och 365 nm, som bör anpassas till bindningsmaterialets optiska absorptionsegenskaper.
Kemisk avbindning
Kemisk avbindning uppnår separationer av bundna wafers genom att lösa upp det bindande limskiktet med ett särskilt kemiskt lösningsmedel. Denna process kräver att lösningsmedelsmolekyler penetrerar det vidhäftande skiktet för att orsaka svullnad, kedjeklyvning och eventuell upplösning, vilket gör att ultratunna wafers och bärarsubstrat kan separeras naturligt. Därför krävs ingen ytterligare uppvärmningsutrustning eller mekanisk kraft som tillhandahålls av vakuumchuckar, kemisk avbindning genererar minimal påfrestning på wafers.
I denna metod är bärarskivor ofta förborrade för att tillåta lösningsmedel att helt komma i kontakt med och lösa upp bindningsskiktet. Limtjockleken påverkar effektiviteten och likformigheten av lösningsmedelspenetration och upplösning. Lösliga bindemedel är mestadels termoplastiska eller modifierade polyimidbaserade material, vanligtvis applicerade genom spin-coating.
Mekanisk avbindning
Mekanisk avbindning separerar ultratunna wafers från de tillfälliga bärarsubstraten enbart genom att applicera kontrollerad mekanisk avskalningskraft, utan värme, kemiska lösningsmedel eller lasrar. Processen liknar att dra av tejpen, där wafern försiktigt "lyfts upp" genom mekanisk precisionsoperation.
Semicorex erbjuder hög kvalitetSIC porösa keramiska debonding-chuckar. Om du har några frågor eller behöver ytterligare information, tveka inte att kontakta oss.
Kontakta telefonnummer +86-13567891907
E-post: sales@semicorex.com




