
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Förstå den kompletta tillverkningsprocessen för halvledarenheter
1. Fotolitografi
Fotolitografi, ofta synonymt med mönstergenerering, är en av de mest kritiska drivkrafterna bakom den snabba utvecklingen av halvledarteknologi, som härrör från fotografiska plåttillverkningsprocesser vid tryckning. Denna teknik möjliggör presentation av alla mönster i mikro- eller nanoskala med hjälp av fotoresist, och när de kombineras med andra processteknologier överförs dessa mönster till material, och realiserar olika konstruktioner och koncept för halvledarmaterial och -enheter. Ljuskällan som används i fotolitografi påverkar direkt mönstrens precision, med alternativ som sträcker sig från ultraviolett, djup ultraviolett, till röntgenstrålar och elektronstrålar, var och en motsvarar ökande nivåer av mönstertrohet i nämnd ordning.
Ett standardfotolitografiprocessflöde inkluderar ytförberedelse, vidhäftning, mjukgräddning, exponering, bakning efter exponering, framkallning, hårdgräddning och inspektion.
Ytbehandling är absolut nödvändig eftersom substrat vanligtvis absorberar H2O-molekyler från luften, vilket är skadligt för fotolitografi. Därför genomgår substrat initialt uttorkningsbearbetning genom bakning.
För hydrofila substrat är deras vidhäftning till hydrofob fotoresist otillräcklig, vilket potentiellt kan orsaka fotoresistlossning eller mönsterförskjutning, sålunda behovet av en adhesionspromotor. För närvarande är hexametyldisilazan (HMDS) och tri-metyl-silyl-dietylamin (TMSDEA) allmänt använda adhesionsförstärkare.
Efter ytbehandling börjar appliceringen av fotoresist. Tjockleken på den applicerade fotoresisten är inte bara relaterad till dess viskositet utan påverkas också av spinnbeläggningshastigheten, i allmänhet omvänt proportionell mot kvadratroten av spinnhastigheten. Efter beläggning utförs en mjuk bakning för att avdunsta lösningsmedlet från fotoresisten, vilket förbättrar vidhäftningen i en process som kallas förbakningen.
När dessa steg är klara sker exponering. Fotoresister klassificeras som positiva eller negativa, med motsatta egenskaper efter exponering.
Ta positiv fotoresist som ett exempel, där oexponerad fotoresist är olöslig i framkallare, men blir löslig efter exponering. Under exponeringen belyser ljuskällan, som passerar genom en mönstrad mask, det belagda substratet och mönstrar fotoresisten. Normalt måste substratet vara inriktat med masken före exponering för att exakt kontrollera exponeringspositionen. Exponeringens varaktighet måste hanteras strikt för att förhindra mönsterförvrängning. Efter exponering kan ytterligare bakning krävas för att mildra effekterna av stående vågor, även om detta steg är valfritt och kan kringgås till förmån för direkt utveckling. Framkallning löser upp den exponerade fotoresisten och överför maskmönstret exakt till fotoresistskiktet. Utvecklingstiden är också kritisk - för kort leder till ofullständig utveckling, för lång orsakar mönsterförvrängning.
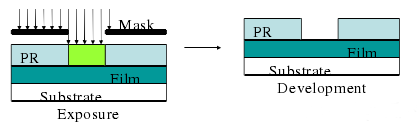
Därefter stärker hårdgräddning fästet av fotoresistfilmen till substratet och förbättrar dess etsningsmotstånd. Den hårda gräddningstemperaturen är i allmänhet något högre än den för förbakningen.
Slutligen verifierar mikroskopisk inspektion om mönstret överensstämmer med förväntningarna. Efter att mönstret har överförts till materialet genom andra processer har fotoresisten tjänat sitt syfte och måste tas bort. Strippningsmetoder inkluderar våta (med starka organiska lösningsmedel som aceton) och torra (med syreplasma för att etsa bort filmen).
2. Dopingtekniker
Doping är oumbärlig i halvledarteknik, och ändrar de elektriska egenskaperna hos halvledarmaterial efter behov. De vanliga dopningsmetoderna inkluderar termisk diffusion och jonimplantation.
(1) Jonimplantation
Jonimplantation dopar halvledarsubstratet genom att bombardera det med högenergijoner. Jämfört med termisk diffusion har den många fördelar. Jonerna, valda av en massanalysator, säkerställer hög dopningsrenhet. Under hela implantationen förblir substratet vid rumstemperatur eller något över. Många maskeringsfilmer kan användas, såsom kiseldioxid (SiO2), kiselnitrid (Si3N4) och fotoresist, vilket ger hög flexibilitet med självjusterande masktekniker. Implantatdoserna är noggrant kontrollerade, och den implanterade föroreningsjonfördelningen är enhetlig inom samma plan, vilket resulterar i hög repeterbarhet.
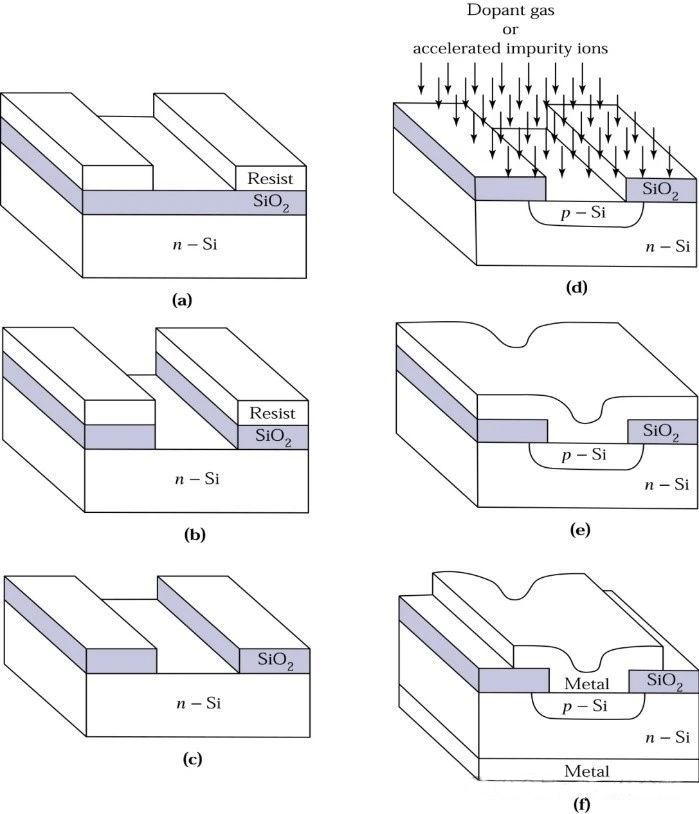
Implantationsdjupet bestäms av jonernas energi. Genom att reglera energin och dosen kan fördelningen av föroreningsjoner i substratet efter implantation manipuleras. Flera implantationer med olika scheman kan utföras kontinuerligt för att uppnå olika föroreningsprofiler. Särskilt i enkristallsubstrat, om implantationsriktningen är parallell med den kristallografiska riktningen, uppstår kanaleffekter - vissa joner kommer att färdas längs kanaler, vilket gör djupkontroll utmanande.
För att förhindra kanalisering utförs implantation typiskt i en vinkel på ungefär 7° mot huvudaxeln för enkristallsubstratet eller genom att täcka substratet med ett amorft skikt.
Emellertid kan jonimplantation avsevärt skada kristallstrukturen hos substratet. Högenergijoner överför vid kollision energi till substratets kärnor och elektroner, vilket gör att de lämnar gittret och bildar interstitiell-vakansdefektpar. I svåra fall kan kristallstrukturen i vissa regioner förstöras och bilda amorfa zoner.
Gitterskada påverkar i hög grad halvledarmaterialets elektriska egenskaper, såsom att minska bärarens rörlighet eller livslängden för icke-jämviktsbärare. Viktigast av allt är att majoriteten av implanterade föroreningar upptar oregelbundna interstitiella ställen och misslyckas med att bilda effektiv dopning. Därför är reparation av gallerskada efter implantation och elektrisk aktivering av föroreningar väsentliga.
(2)Rapid Thermal Processing (RTP)
Termisk glödgning är den mest effektiva metoden för att korrigera gallerskador orsakade av jonimplantation och elektriskt aktiverande föroreningar. Vid höga temperaturer kommer interstitiella vakansdefektpar i substratets kristallgitter att rekombinera och försvinna; amorfa regioner kommer också att omkristallisera från gränsen med enkristallområden via fastfas epitaxi. För att förhindra att substratmaterialet oxiderar vid höga temperaturer måste termisk glödgning utföras i vakuum eller inert gasatmosfär. Traditionell glödgning tar lång tid och kan orsaka betydande omfördelning av föroreningar på grund av diffusion.
Tillkomsten avRTP-tekniklöser detta problem, och åstadkommer till stor del reparation av gallerskada och aktivering av föroreningar inom en förkortad glödgningstid.
Beroende på värmekällan,RTPär kategoriserad i flera typer: elektronstrålescanning, pulsade elektron- och jonstrålar, pulsade lasrar, kontinuerliga våglasrar och bredbands inkoherenta ljuskällor (halogenlampor, grafitvärmare, båglampor), där de sistnämnda är de mest använda. Dessa källor kan värma substratet till önskad temperatur på ett ögonblick, avsluta glödgningen på kort tid och effektivt reducera föroreningsdiffusion.
3. Filmavsättningstekniker
(1) Plasmaförstärkt kemisk ångdeposition (PECVD)
PECVD är en form av kemisk ångavsättning (CVD) teknik för filmavsättning, med de andra två är Atmospheric Pressure CVD (APCVD) och Low Pressure CVD (LPCVD).
För närvarande är PECVD den mest använda bland de tre typerna. Den använder radiofrekvensplasma (RF) för att initiera och upprätthålla kemiska reaktioner vid relativt låga temperaturer, vilket underlättar lågtemperaturfilmavsättning med höga avsättningshastigheter. Dess utrustningsschema är som illustreras.
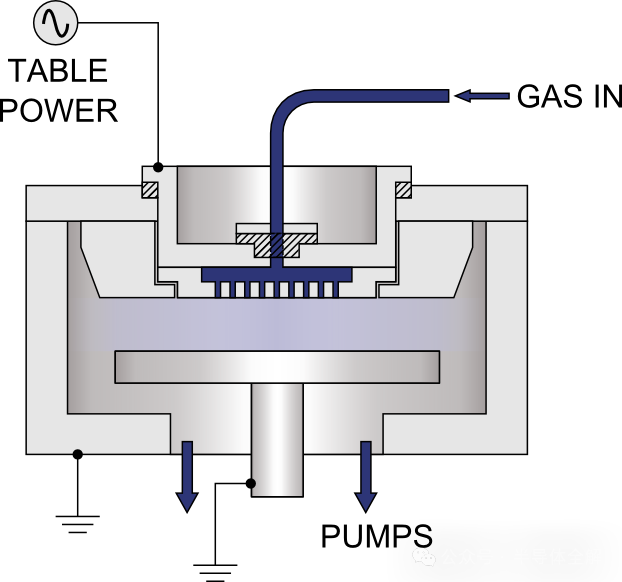
Filmer producerade med denna metod uppvisar exceptionella vidhäftnings- och elektriska egenskaper, minimal mikroporositet, hög enhetlighet och robusta småskaliga fyllningsförmåga. Faktorer som påverkar kvaliteten på PECVD-avsättning inkluderar substrattemperatur, gasflödeshastighet, tryck, RF-effekt och frekvens.
(2) Sputtring
Sputtering är en fysisk ångavsättningsmetod (PVD). Laddade joner (vanligtvis argonjoner, Ar+) accelereras i ett elektriskt fält och får kinetisk energi. De är riktade mot målmaterialet, kolliderar med målmolekyler och får dem att lossna och sprattla iväg. Dessa molekyler har också betydande kinetisk energi och rör sig mot substratet och avsätter sig på det.

Typiskt använda sputterkraftkällor inkluderar likström (DC) och radiofrekvens (RF), där DC-förstoftning är direkt tillämpbar på ledande material som metaller, medan isoleringsmaterial kräver RF-förstoftning för filmavsättning.
Konventionell förstoftning lider av låga avsättningshastigheter och höga arbetstryck, vilket resulterar i lägre filmkvalitet. Magnetronförstoftning löser dessa problem mer idealiskt. Den använder ett externt magnetfält för att ändra jonernas linjära bana till en spiralformad bana runt magnetfältets riktning, vilket förlänger deras bana och förbättrar kollisionseffektiviteten med målmolekyler, vilket förbättrar sputtringseffektiviteten. Detta resulterar i ökade avsättningshastigheter, minskat arbetstryck och avsevärt förbättrad filmkvalitet.
4. Etsning Tekniker
Etsning klassificeras i torra och våta lägen, namngivna efter deras användning (eller brist på) specifika lösningar.
Typiskt kräver etsning förberedelse av ett maskskikt (som direkt kan vara fotoresist) för att skydda områden som inte är avsedda för etsning.
(1) Torretsning
Vanliga torretsningstyper inkluderarInductively Coupled Plasma (ICP) etsning, jonstråleetsning (IBE) och reaktiv jonetsning (RIE).
Vid ICP-etsning innehåller den glödurladdningsproducerade plasman ett flertal mycket kemiskt aktiva fria radikaler (fria atomer, molekyler eller atomgrupper), som reagerar kemiskt med målmaterialet för att bilda flyktiga produkter, och på så sätt uppnå etsning.
IBE använder högenergijoner (joniserade från inerta gaser) för att direkt bombardera målmaterialets yta för etsning, vilket representerar en fysisk process.
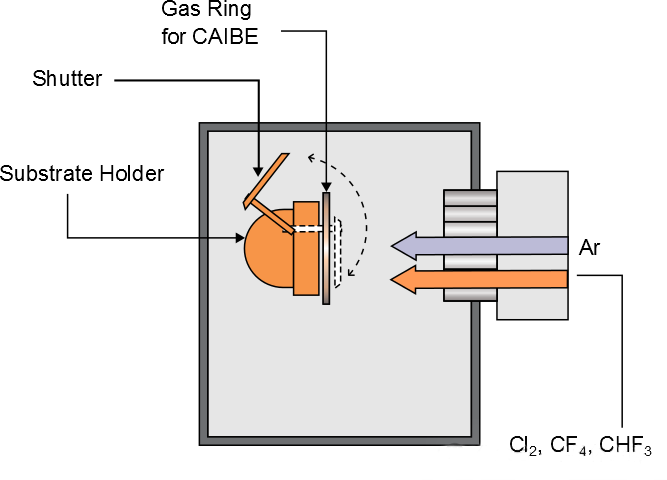
RIE anses vara en kombination av de två föregående, som ersätter den inerta gasen som används i IBE med gasen som används vid ICP-etsning, och utgör därmed RIE.
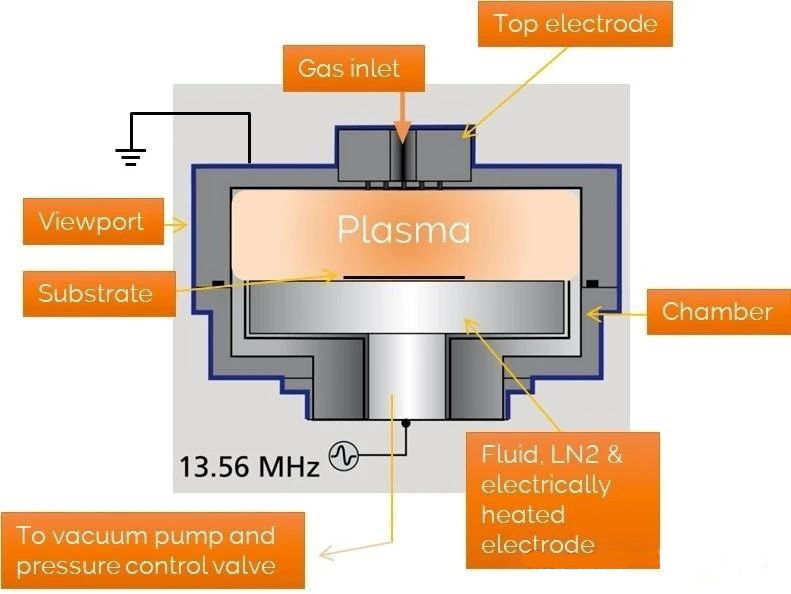
För torretsning överstiger den vertikala etsningshastigheten vida den laterala hastigheten, dvs den har ett högt bildförhållande, vilket tillåter exakt replikering av maskmönstret. Men torretsning etsar också maskskiktet, vilket visar sämre selektivitet (förhållandet mellan etsningshastigheter av målmaterial och maskskikt), speciellt med IBE, som kan etsa icke-selektivt över materialets yta.
(2) Våtetsning
Våtetsning betecknar metoden för etsning som uppnås genom nedsänkning av målmaterialet i en lösning (etsmedel) som kemiskt reagerar med det.
Denna etsmetod är enkel, kostnadseffektiv och visar god selektivitet men har ett lågt bildförhållande. Materialet under maskens kanter kan korroderas, vilket gör det mindre exakt än torretsning. För att mildra de negativa effekterna av ett lågt bildförhållande måste lämpliga etsningshastigheter väljas. Faktorer som påverkar etsningshastigheten inkluderar etsmedelskoncentration, etsningstid och etsmedelstemperatur.**




