
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe in Chip Manufacturing: A Professional News Report
Utvecklingen av halvledarmaterial
Inom den moderna halvledarteknikens område har den obevekliga drivkraften mot miniatyrisering flyttat gränserna för traditionella kiselbaserade material. För att möta kraven på hög prestanda och låg strömförbrukning har SiGe (Silicon Germanium) framstått som ett valfritt kompositmaterial vid tillverkning av halvledarchips på grund av dess unika fysiska och elektriska egenskaper. Den här artikeln fördjupar sig iepitaxiprocessav SiGe och dess roll i epitaxiell tillväxt, ansträngda kiselapplikationer och Gate-All-Around (GAA) strukturer.
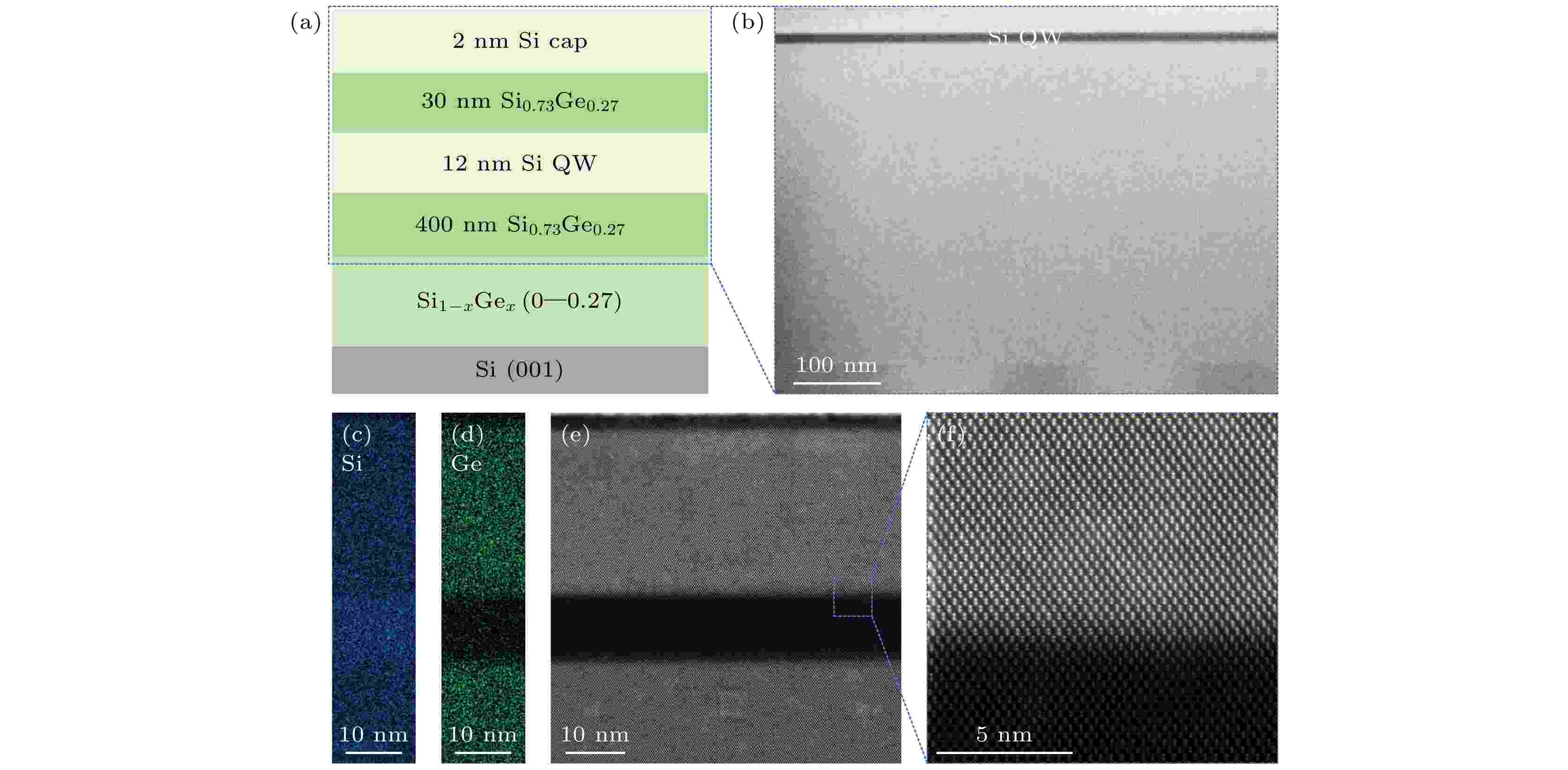
Betydelsen av SiGe-epitaxi
1.1 Introduktion till epitaxi i chiptillverkning:
Epitaxi, ofta förkortat som Epi, hänvisar till tillväxten av ett enkristalllager på ett enkristallsubstrat med samma gitterarrangemang. Detta lager kan vara antingenhomoepitaxial (som Si/Si)eller heteroepitaxial (såsom SiGe/Si eller SiC/Si). Olika metoder används för epitaxiell tillväxt, inklusive Molecular Beam Epitaxi (MBE), Ultra-High Vacuum Chemical Vapor Deposition (UHV/CVD), Atmospheric and Reduced Pressure Epitaxi (ATM & RP Epi). Den här artikeln fokuserar på epitaxiprocesserna för kisel (Si) och kisel-germanium (SiGe) som ofta används i produktion av integrerade halvledarkretsar med kisel som substratmaterial.
1.2 Fördelar med SiGe Epitaxy:
Inkorporering av en viss andel germanium (Ge) underepitaxiprocessbildar ett SiGe enkristalllager som inte bara minskar bandgapets bredd utan också ökar transistorns gränsfrekvens (fT). Detta gör den mycket användbar i högfrekventa enheter för trådlös och optisk kommunikation. Dessutom, i avancerade CMOS-integrerade kretsprocesser, introducerar gittermissanpassningen (cirka 4%) mellan Ge och Si gitterspänning, vilket förbättrar rörligheten för elektroner eller hål och därmed ökar enhetens mättnadsström och svarshastighet.
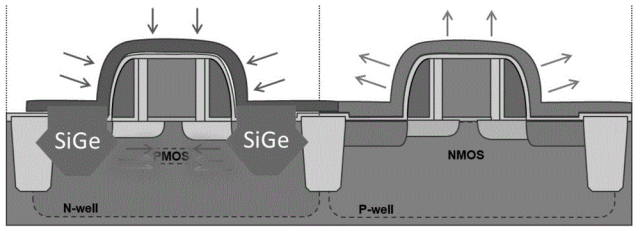
Det omfattande SiGe-epitaxiprocessflödet
2.1 Förbehandling:
Kiselwafers förbehandlas baserat på de önskade processresultaten, främst med att ta bort det naturliga oxidskiktet och föroreningar på waferns yta. För kraftigt dopade substratskivor är det avgörande att överväga om bakförsegling är nödvändig för att minska autodoping under efterföljandeepitaxitillväxt.
2.2 Tillväxtgaser och förhållanden:
Kiselgaser: Silan (SiH4), diklorsilan (DCS, SiH2Cl2) och triklorsilan (TCS, SiHCl3) är de tre mest använda kiselgaskällorna. SiH4 är lämplig för lågtemperaturfulla epitaxiprocesser, medan TCS, känd för sin snabba tillväxthastighet, används allmänt för beredning av tjockakiselepitaxilager.
Germaniumgas: Germane (GeH₄) är den primära källan för tillsats av germanium, som används tillsammans med kiselkällor för att bilda SiGe-legeringar.
Selektiv epitaxi: Selektiv tillväxt uppnås genom att justera de relativa hastigheterna förepitaxiell avsättningoch in situ etsning med användning av klorinnehållande kiselgas DCS. Selektiviteten beror på att adsorptionen av Cl-atomer på kiselytan är mindre än den på oxider eller nitrider, vilket underlättar epitaxiell tillväxt. SiH4, som saknar Cl-atomer och med låg aktiveringsenergi, appliceras i allmänhet endast på lågtemperaturfulla epitaxiprocesser. En annan vanligen använd kiselkälla, TCS, har lågt ångtryck och är flytande vid rumstemperatur, vilket kräver H2-bubbling för att införa det i reaktionskammaren. Det är dock relativt billigt och används ofta för sin snabba tillväxthastighet (upp till 5 μm/min) för att odla tjockare kiselepitaxiskikt, allmänt applicerade i produktion av kiselepitaxskivor.
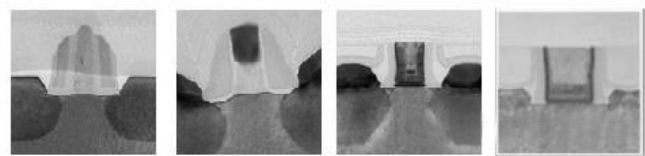
Silikon i epitaxiella lager
Underepitaxiell tillväxt, avsätts epitaxiell enkristall-Si på ett avslappnat SiGe-skikt. På grund av gittermissanpassningen mellan Si och SiGe utsätts Si-enkristallskiktet för dragspänning från det underliggande SiGe-skiktet, vilket avsevärt förbättrar elektronrörligheten i NMOS-transistorer. Denna teknik ökar inte bara mättnadsströmmen (Idsat) utan förbättrar också enhetens svarshastighet. För PMOS-enheter odlas SiGe-skikt epitaxiellt i käll- och dräneringsområdena efter etsning för att införa tryckspänning på kanalen, vilket förbättrar hålrörligheten och ökar mättnadsströmmen.
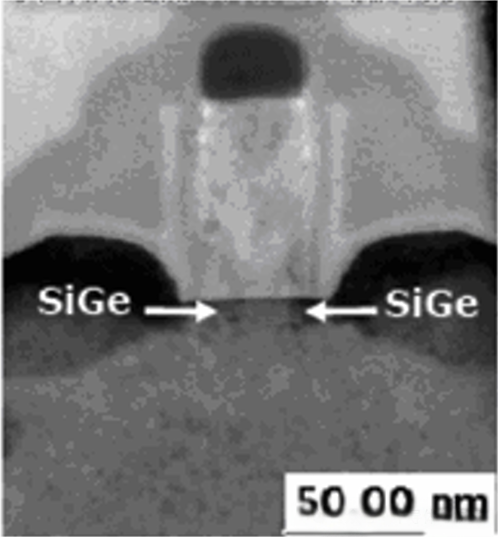
SiGe som ett offerlager i GAA-strukturer
Vid tillverkning av Gate-All-Around (GAA) nanotrådstransistorer fungerar SiGe-lager som offerlager. Anisotropiska etsningstekniker med hög selektivitet, såsom kvasiatomär lageretsning (quasi-ALE), möjliggör exakt borttagning av SiGe-lager för att bilda nanotråds- eller nanoarkstrukturer.
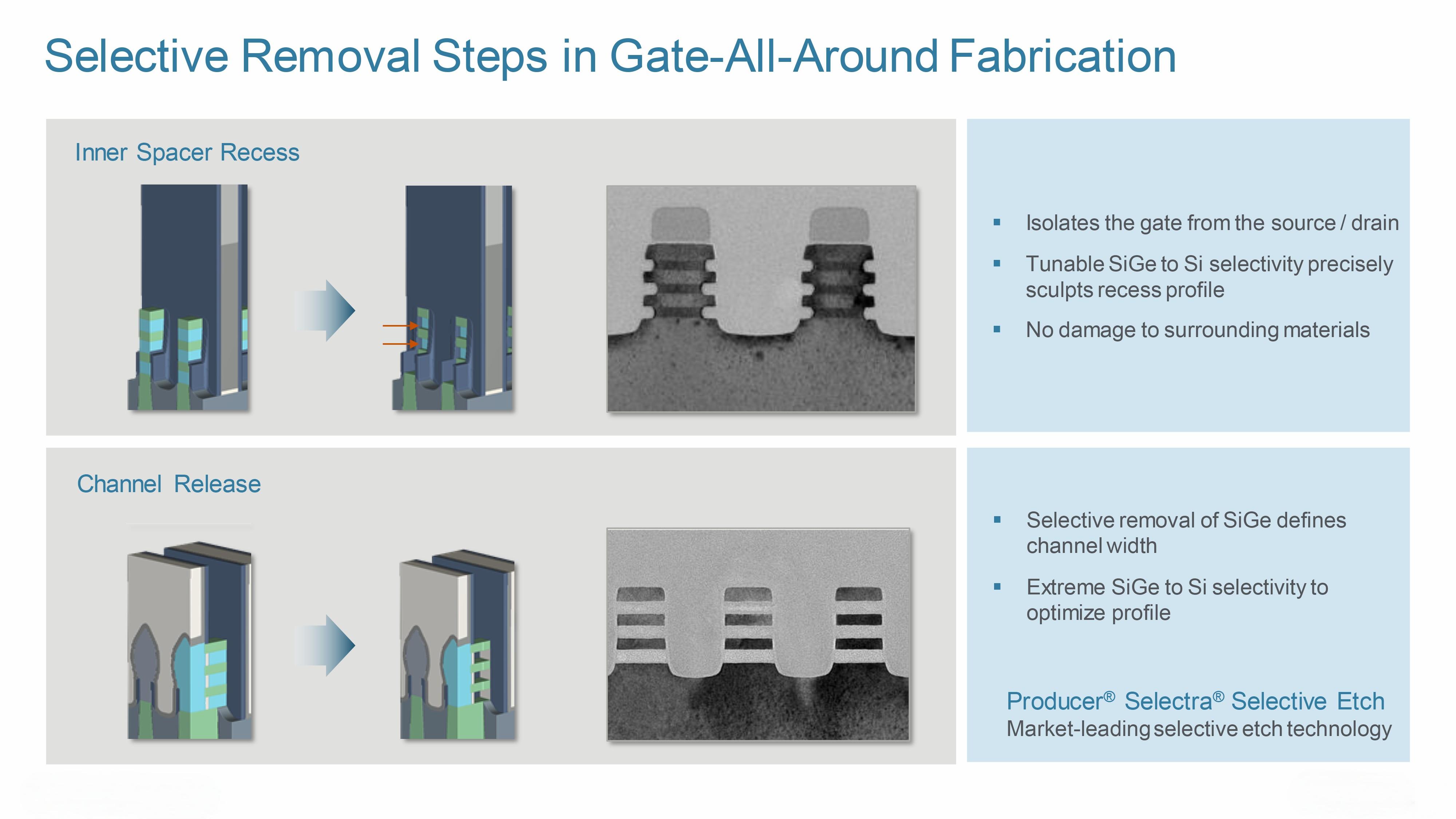
Vi på Semicorex är specialiserade påSiC/TaC-belagda grafitlösningartillämpas i Si epitaxiell tillväxt i halvledartillverkning, om du har några frågor eller behöver ytterligare information, tveka inte att kontakta oss.
Kontakttelefon: +86-13567891907
E-post: sales@semicorex.com




