
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe och Si Selective Etching Technology
Gate-All-Around FET (GAAFET), som en nästa generations transistorarkitektur som är redo att ersätta FinFET, har fått stor uppmärksamhet för sin förmåga att tillhandahålla överlägsen elektrostatisk kontroll och förbättrad prestanda vid mindre dimensioner. Ett kritiskt steg i tillverkningen av GAAFET av n-typ involverar hög selektivitetetsningav SiGe:Si-staplar före deponering av inre distanser, genererar kiselnanoskivor och frigör kanaler.

Den här artikeln fördjupar sig i det selektivaetsningsteknikerinvolverad i denna process och introducerar två nya etningsmetoder – plasmafri etsning med hög oxidativ gas och etsning av atomskikt (ALE) – som erbjuder nya lösningar för att uppnå hög precision och selektivitet i SiGe-etsning.
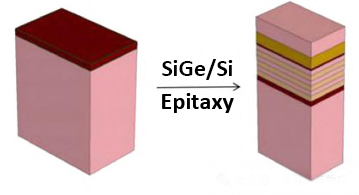
SiGe Superlattice-lager i GAA-strukturer
I utformningen av GAAFETs, för att förbättra enhetens prestanda, är alternerande lager av Si och SiGeepitaxiellt odlad på ett kiselsubstratbildar en flerskiktsstruktur känd som ett supergitter. Dessa SiGe-lager justerar inte bara bärarkoncentrationen utan förbättrar också elektronrörlighet genom att introducera stress. Men i efterföljande processsteg måste dessa SiGe-skikt tas bort exakt samtidigt som kiselskikten behålls, vilket kräver mycket selektiv etsningsteknik.
Metoder för selektiv etsning av SiGe
Plasmafri etsning med hög oxidativ gas
Valet av ClF3-gas: Denna etsmetod använder mycket oxidativa gaser med extrem selektivitet, såsom ClF3, vilket uppnår ett SiGe:Si-selektivitetsförhållande på 1000-5000. Det kan göras i rumstemperatur utan att orsaka plasmaskada.
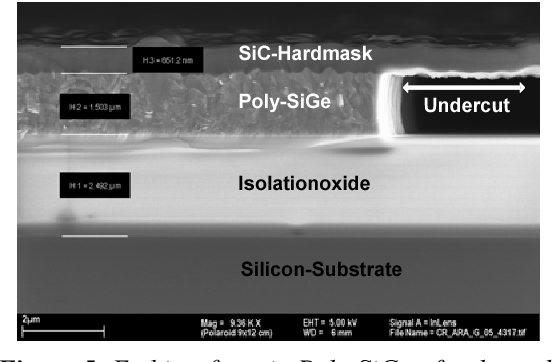
Lågtemperatureffektivitet: Den optimala temperaturen är runt 30°C, vilket ger hög selektiv etsning under lågtemperaturförhållanden, undviker ytterligare termiska budgetökningar, vilket är avgörande för att bibehålla enhetens prestanda.
Torr miljö: Helaetsningsprocessutförs under helt torra förhållanden, vilket eliminerar risken för strukturvidhäftning.
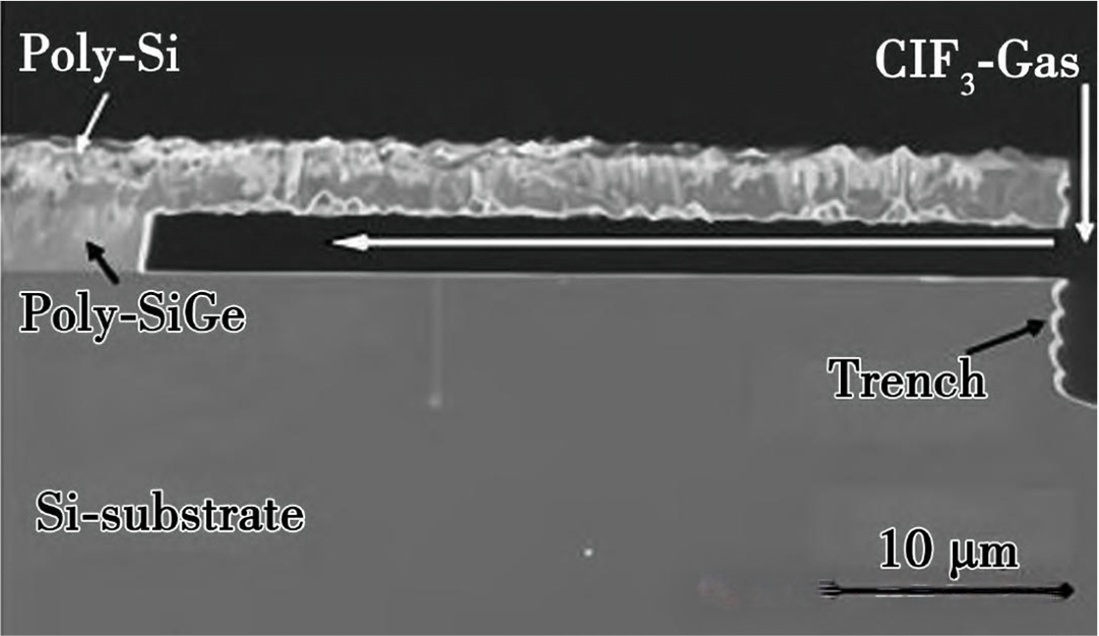
Atomic Layer Etching (ALE)
Självbegränsande egenskaper: ALE är en tvåstegscyklisketsningsteknikdär ytan på materialet som ska etsas först modifieras, och sedan avlägsnas det modifierade skiktet utan att påverka de omodifierade delarna. Varje steg är självbegränsande, vilket säkerställer precision till nivån för att ta bort bara några atomlager åt gången.
Cyklisk etsning: De ovan nämnda två stegen cyklas upprepade gånger tills det önskade etsningsdjupet uppnås. Denna process gör det möjligt för ALE att uppnåprecisionsetsning på atomnivåi små hålrum på innerväggarna.

Vi på Semicorex är specialiserade påSiC/TaC-belagda grafitlösningartillämpas i Etsningsprocesser i halvledartillverkning, om du har några frågor eller behöver ytterligare information, tveka inte att kontakta oss.
Kontakttelefon: +86-13567891907
E-post: sales@semicorex.com




